Ball Grid Array (BGA) megfigyelése és mérése digitális mikroszkóppal
Az 5. generációs mobilkommunikációs rendszerek (5G) elterjedésével még kisebb és integráltabb félvezető eszközöket vezettek be, valamint megnőtt az igény a termékellenőrzésre és elemzésre is.
Ebben a részben példákat mutatunk a BGA-k kiemelkedéseinek megfigyelésére és mérésére, melyeket gyakran vizsgálnak digitális mikroszkópokkal.
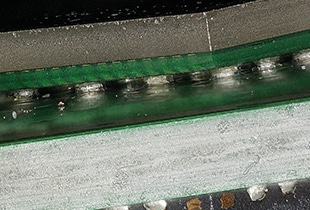
- Tipikus IC tokozások
- IC chiprögzítés tipikus kötése
- Golyókészítési módszerek flip-chip kötéshez
- Példák a BGA-k (kiemelkedések) megfigyelésére és mérésére digitális mikroszkóppal
Tipikus IC tokozások
Ahogyan az IC-k egyre integráltabbá váltak, elterjedt a felületszerelési technológia (SMT). A nagy mértékben integrált IC-khez mátrixos (BGA típusú) tokozásokat használnak.
Ebben a részben bemutatjuk a következő tipikus IC tokozásokat.
Felületszereléses technológia (SMT): láb nélküli tokozás
- SON (kis kerületű láb nélküli) tokozás
-

Ezek lábak nélküli SMT tokozások. Csatlakozó érintkezőként elektródalapokat használnak. A SON kétutas tokozás, amit kevés láb esetén használnak.
- QFN (quad lapos láb nélküli) tokozás
-

Ezek lábak nélküli SMT tokozások. Csatlakozó érintkezőként elektródalapokat használnak. A QFN négyutas tokozás.
Felületszereléses technológia (SMT): mátrix tokozás
- BGA (ball grid array)
-

A forraszanyag golyói a tokozás alján vannak sorba rendezve, ahol érintkezőként szolgálnak.
- PGA (pin grid array)
-
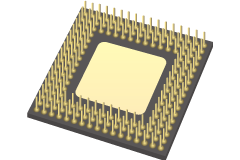
A lábak a tokozás alján vannak sorba rendezve, ahol érintkezőként szolgálnak.
- LGA (land grid array)
-
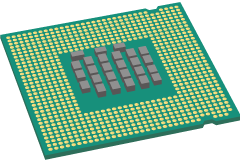
Az elektródalapok (többek között rézlapok) a tokozás alján vannak sorba rendezve, ahol érintkezőként szolgálnak.
IC chiprögzítés tipikus kötése
- Huzalkötés
-
A huzalkötést arra használják, hogy a félvezető chipek elektródáit vékony arany-, alumínium- vagy rézhuzalokkal összekapcsolják a kivezető keretek vagy lemezek elektromos vezetőivel.

- Flip-chip kötés
-
Azt a módszert, amikor az IC chipeket közvetlenül a NYÁK-ra rögzítik, FC-BGA-nak (Flip Chip-BGA) nevezik. Az IC chip elektródáin kiemelkedéseket készítenek, amelyeket a NYÁK elektródáihoz kapcsolnak. Ezzel a huzalkötéshez képest helyet takarítanak meg.

- Balra: IC chip
- Jobbra: Flip (lefelé néz)
Golyókészítési módszerek flip-chip kötéshez
- Forraszanyag golyó rögzítése
- Előre elkészítik a forraszanyag golyókat, elhelyezik az elektródákon, majd megfolyasztják, hogy kiemelkedéseket hozzanak létre. A pasztanyomtatáshoz képest nagyobb kiemelkedéseket lehet létrehozni. A forraszanyag golyók méretének egységesítése megelőzi a kiemelkedések magasságbeli eltérését.
- Pasztanyomtatás
- Forrasztópasztát nyomtatnak az elektródákra, majd megfolyasztják, hogy kiemelkedéseket hozzanak létre. Az áteresztőképesség nagy, de nehéz egységes magasságú kiemelkedéseket létrehozni.
- Galvanizálás
- A forraszanyag kiemelkedéseit galvanizálással hozzák létre. Finom kiemelkedéseket lehet létrehozni, de az áteresztőképesség alacsony.
Példák a BGA-k (kiemelkedések) megfigyelésére és mérésére digitális mikroszkóppal
Bemutatjuk a legújabb példákat a BGA-k (kiemelkedések) megfigyelésére és mérésére a KEYENCE VHX sorozat 4K-s digitális mikroszkópjával.

100×, gyűrűs megvilágítás
A döntött megfigyelés lehetővé teszi a BGA golyók megfigyelését a NYÁK-on lévő résen keresztül.
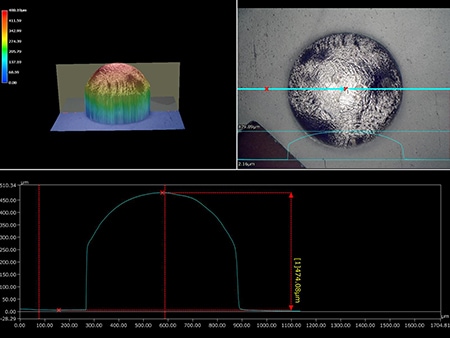
300×, kevert megvilágítás (csillanás-eltávolításos kép)
A kevert megvilágítás és a csillanás-eltávolítás lehetővé teszi a becsillanásmentes megfigyelést.