Pozorování a měření kuličkových mřížkových polí (BGA) pomocí digitálního mikroskopu
Rozšíření mobilních komunikačních systémů 5. generace (5G) vedlo k tomu, že se polovodičová zařízení stala menšími a integrovanějšími, a také zvýšilo poptávku po kontrole a analýze výrobků.
Tato část představuje příklady pozorování a měření hrbolků BGA, které jsou běžnými pozorovacími cíli pro digitální mikroskopy.
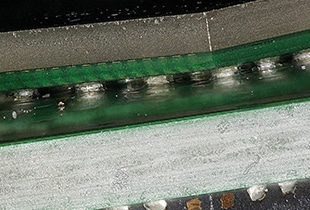
- Typická pouzdra integrovaných obvodů
- Typické bondování pro montáž čipů integrovaných obvodů
- Metody vytváření výčnělků pro bondování obrácených čipů
- Příklady pozorování a měření BGA (výčnělky) pomocí digitálního mikroskopu
Typická pouzdra integrovaných obvodů
Vzhledem k tomu, že integrované obvody se stávají integrovanějšími integrovanými obvody, technologie povrchové montáže (SMT) se stala hlavním proudem. Maticová pouzdra (typ BGA) se používají pro vysoce integrované obvody.
Tato část představuje následující typická pouzdra integrovaných obvodů.
Technologie povrchové montáže (SMT): Pouzdro bez olova
- Pouzdro SON (malé provedení bez olova)
-

Jedná se o pouzdra SMT bez obsahu olova. Jako připojovací koncovky se používají elektrodové podložky. SON jsou dvoucestné typy pouzder používané pro malý počet pinů.
- Pouzdro QFN (čtyřnásobné ploché bez olova)
-

Jedná se o pouzdra SMT bez obsahu olova. Jako připojovací koncovky se používají elektrodové podložky. QFN jsou pouzdra čtyřcestného typu.
Technologie povrchové montáže (SMT): Maticové pouzdro
- BGA (kuličkové mřížkové pole)
-

Pájecí kuličky (ve tvaru koule) jsou umístěny na spodní straně pouzdra a slouží jako koncovky.
- PGA (kolíkové mřížkové pole)
-
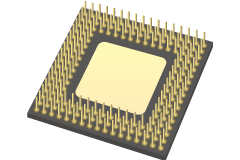
Na spodní straně pouzdra jsou umístěny kolíky, které lze použít jako koncovky.
- LGA (ploché pole mřížky)
-
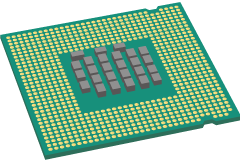
Elektrodové podložky (včetně měděných podložek) jsou umístěny na spodní straně pouzdra a slouží jako koncovky.
Typické bondování pro montáž čipů integrovaných obvodů
- Bondování
-
Bondování se používá k připojení elektrod polovodičových čipů k elektrickým vodičům olověných rámů nebo desek s tenkými drátky ze zlata, hliníku nebo mědi.

- Bondování obrácených čipů
-
Metoda, kdy jsou čipy integrovaných obvodů připojeny přímo k desce plošných spojů, se nazývá FC-BGA (obrácení čipu-BGA). Na elektrodách čipů integrovaných obvodů se vytvoří výčnělky a poté se připojí k elektrodám desky plošných spojů. To šetří místo ve srovnání s bondováním.

- Vlevo: Čipy integrovaných obvodů
- Napravo: Obrácený (čelem dolů)
Metody vytváření výčnělků pro bondování obrácených čipů
- Montáž pájecí kuličky
- Pájecí kuličky jsou vyrobeny předem, umístěny na elektrody a poté přetaveny, aby se vytvořily výčnělky. Lze vytvořit větší výčnělky, než je možné u pastového tisku. Sjednocení velikosti pájecích kuliček také zabraňuje výškovým rozdílům výčnělků.
- Pastový tisk
- Pájecí pasta se natiskne na elektrody a poté se přetaví, aby se vytvořily výčnělky. Propustnost je vysoká, ale sjednotit výšku výčnělků je obtížné.
- Pokovování
- Galvanické pokovování se používá k výrobě pájecích výčnělků. Lze vytvořit jemné výčnělky, ale propustnost je nízká.
Příklady pozorování a měření BGA (výčnělky) pomocí digitálního mikroskopu
Nejnovější příklady pozorování a měření snímků BGA (výčnělky) pomocí digitálního 4K mikroskopu KEYENCE řady VHX jsou uvedeny níže.
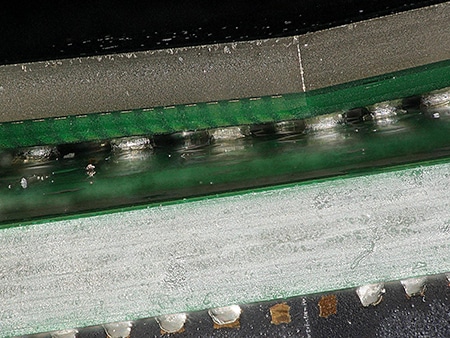
100×, kruhové osvětlení
Nakloněné pozorování umožňuje pozorování kuliček BGA přes vůli na desce plošných spojů.
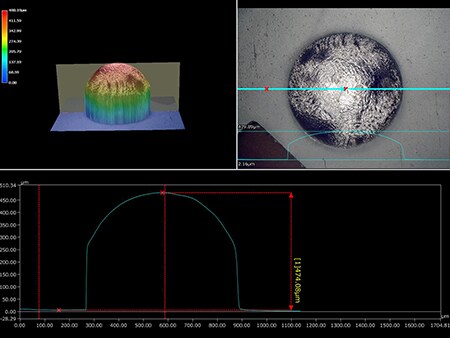
300×, smíšené osvětlení (snímek s odstraněním odlesků)
Smíšené osvětlení a funkce odstranění odlesků umožňují pozorování bez odlesků.