Observation et mesure de boîtiers BGA avec un microscope numérique
En raison du déploiement du système de communication mobile cinquième génération (5G), les dispositifs à semi-conducteur sont de plus en plus petits et intégrés et la demande de contrôle et d'analyse des produits a augmenté.
Cette section présente des exemples d'observation et de mesure de bossages de boîtiers BGA, des cibles d’observation courantes dans le cas des microscopes numériques.
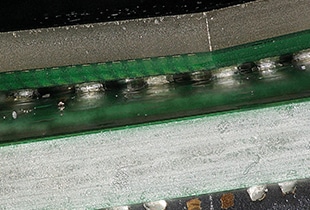
- Boîtiers de circuit intégré types
- Liaison type pour le montage de puces électroniques
- Procédés de formation de bossages pour une connexion par billes
- Exemples d’observation et de mesure de boîtiers BGA (bossages) avec un microscope numérique
Boîtiers de circuit intégré types
Avec l’utilisation de circuits toujours plus intégrés, le procédé de montage en surface est devenu obsolète. Les boîtiers matriciels (boîtiers BGA) sont utilisés pour les circuits hautement intégrés.
Cette section présente les différents boîtiers types de circuit intégré.
Procédé de montage en surface : Boîtier type « non-lead »
- Boîtier SON (small outline no-leaded)
-

Il s'agit de boîtiers montés en surface ne comportant pas de broches de raccordement. Les électrodes servent de terminaux de liaison. Les boîtiers SON sont de type « deux voies ».
- Boîtier QFN (quad flat no-leaded)
-

Il s'agit de boîtiers montés en surface ne comportant pas de broches de raccordement. Les électrodes servent de terminaux de liaison. Les boîtiers QFN sont de type « quatre voies ».
Procédé de montage en surface : Boîtier matriciel
- Boîtier BGA (à billes)
-

Une matrice de billes de soudure (en forme de sphère), qui servent de terminaux, est réalisée sur la base du boîtier.
- Boîtier PGA (à broches)
-
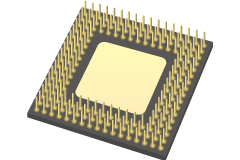
Une matrice de broches, qui servent de terminaux, est réalisée sur la base du boîtier.
- Boîtier LGA (à pastilles)
-
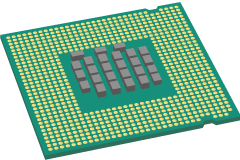
Une matrice d’électrodes (notamment de pastilles en cuivre), qui servent de terminaux, est réalisée sur la base du boîtier.
Liaison type pour le montage de puces électroniques
- Connexion par fils soudés
-
Les connexions par fils servent à connecter des électrodes de puce électronique aux conducteurs électriques de grilles de connexion ou de circuits imprimés à l’aide de fins fils en or, en aluminium ou en cuivre.

- Connexion par billes
-
Lorsque des puces électroniques sont directement connectées à un circuit imprimé, on parle de substrat FC-BGA. Des bossages sont réalisés au niveau des électrodes d’une puce électronique qui sont ensuite connectées à celles d’un circuit imprimé. Cela permet un gain de place par rapport à la connexion par fils.

- Gauche : Puce
- Droite : Puce (retournée)
Procédés de formation de bossages pour une connexion par billes
- Montage de billes de soudure
- Les billes de soudure sont réalisées à l'avance puis placées sur les électrodes. Une refusion est ensuite effectuée pour former des bossages. Il est possible de former des bossages plus hauts qu’avec la pâte à souder. L’uniformisation de la taille des billes de soudure permet d’éviter les écarts de hauteur entre les bossages.
- Pâte à braser
- De la pâte à braser est appliquée sur les électrodes. Une refusion est ensuite effectuée pour former des bossages. Le rendement de cette méthode est élevé mais l’uniformisation de la hauteur des bossages est difficile.
- Placage
- La formation de bossages de soudure est réalisée par galvanoplastie. Les bossages sont uniformes mais le rendement en faible.
Exemples d’observation et de mesure de boîtiers BGA (bossages) avec un microscope numérique
Découvrez ci-dessous les derniers exemples d’observation et d’images de mesure de boîtiers BGA (bossages) avec un microscope numérique 4K Série VHX de KEYENCE.
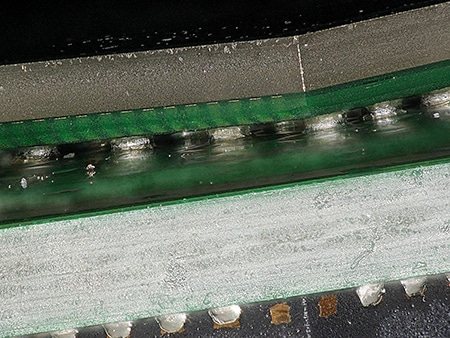
100×, éclairage annulaire
L’observation avec inclinaison permet d’observer les billes d'un boîtier BGA à travers un léger jeu sur un circuit imprimé.
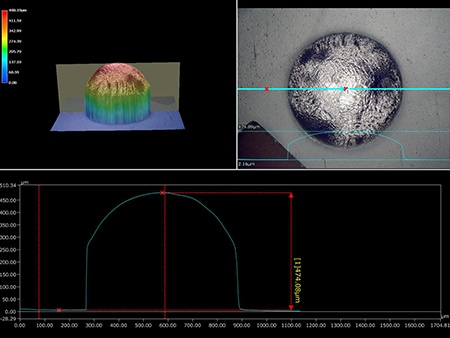
300×, éclairage combiné (image d’élimination des reflets)
L'éclairage combiné et la fonction d'élimination des reflets permet une observation sans reflets.